技術專欄
技術指導:BGA設計規則
126535
27
隨著電子產業技術的進步,芯片集成度不斷提高,IO引腳數急劇增加,功耗也隨之增大,對集成電路封裝的要求也更加嚴格。
為了滿足發展的需要,BGA (Ball Grid Array)-球狀引腳柵格陣列封裝技術被應用于生產,它是在封裝體基板的底部制作陳列
焊球作為電路的I/O端與印刷線路板(PCB)互連,采用該技術封裝的器件是一種表面貼裝器件。

隨著芯片產業的發展,BGA間距越來越小,布線越來越密,以滿足更多功能,此時給生產帶來了不少挑戰:
1)BGA焊盤到線路距離近,且BGA焊盤需要開窗,那么就需要有一定的安全間距,傳統生產中達不到此間距的只能削掉BGA焊盤
2)為了從BGA焊點內部引線出來,常規的做法是在BGA焊盤間做過孔引線,若BGA間距近就沒有再加過孔,只能把過孔鉆在BGA焊盤上
……
這些都給后期的SMT組裝帶來難度與風險,為此,我們更新設備與提升工藝,已解決了這兩大難題:
■ 常規BGA過孔塞油墨生產工藝

■ 高端BGA過孔盤中孔塞樹脂/銅漿生產工藝
塞樹脂/銅漿的應用,使盤中孔成為精密板布線的最佳選擇。同時多層板更新了高端設備,可以制作更精密的BGA焊盤
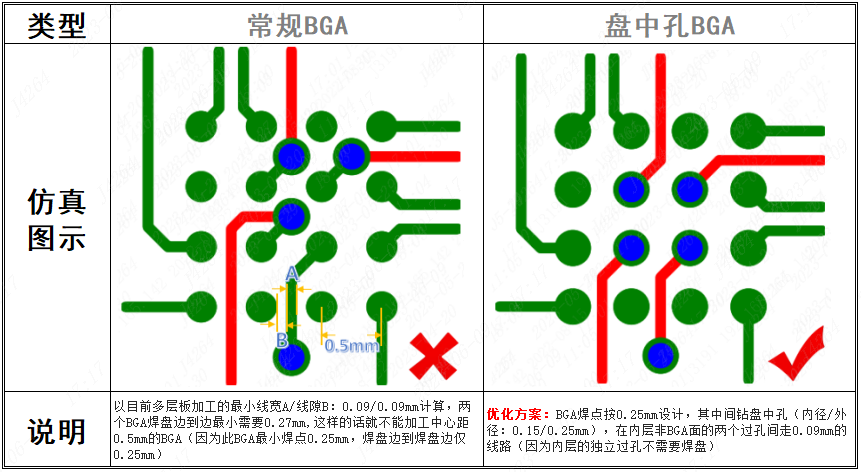
提示:
1)盤中孔中間不能塞油墨,可以塞樹脂或銅漿(銅漿相對樹脂導熱導電性能高),再鍍平BGA盤中孔焊盤
2)采用上述盤中孔塞孔工藝的,盡量把過孔(內徑)做到0.2mm及以上,焊盤(外徑)設計在0.35mm及以上。
3)多層板少部分線寬可以做到極限0.076mm(即3mil),能夠做寬的盡量按0.09mm(即3.5mil)制作
您好,可以設計0.25的BGA焊盤,中間鉆0.15的盤中孔,謝謝!
您好,2層和4層做盤中孔會有相關工藝費,6層及以上免盤中孔工藝費。焊盤直徑0.25mm,中間的盤中孔做0.15mm,謝謝!
您好!0.25mm的過孔不可以呢,可以放0.15mm的過孔,0.25的焊盤做盤中孔工藝,謝謝!
可以制作BGA焊盤0.25mm大小,BGA焊盤邊到焊盤邊最小0.1mm間隙(BGA中間不走線)
您好,過孔焊盤比過孔直徑大0.1mm(建議0.15mm)以上,焊盤邊到焊盤邊最小0.1mm,這樣的話孔邊到焊盤邊最小0.2mm,謝謝!
幾層板?若是多層板,需要搭配好層疊結構,然手盤中孔要改為6mil才可以做。
盤中孔可以做0.25mm的,或是0.3mm也行
BGA焊盤沒有開窗就會蓋上油墨,從而不能組裝BGA元器件
您好,這樣重疊后BGA焊盤也有0.25mm了。謝謝!
內徑0.2mm,外徑0.3mm可以
- 1
- 2
- 3






















